傳ASML布局混合鍵合設備,精準技術優勢或重塑先進封裝市場格局
光刻機龍頭企業阿斯麥(ASML)擬進軍半導體后端設備市場,瞄準高速增長的先進封裝領域,相關傳聞近期再度浮出水面。據韓國媒體《The Elec》消息,阿斯麥已啟動混合鍵合設備的研發工作,該技術被公認為下一代芯片封裝的核心關鍵技術。
有消息人士透露,阿斯麥已著手開展面向后端工藝的混合鍵合系統架構設計,且近期正攜手外部合作伙伴推進該系統的研發工作。
阿斯麥的潛在合作方包括普羅 drive 科技(Prodrive Technologies)與維迪歐 - ETG(VDL-ETG),二者均為阿斯麥供應鏈體系中的長期合作供應商。其中,普羅 drive 科技為阿斯麥極紫外(EUV)光刻機的磁懸浮系統提供直線電機和伺服驅動器,維迪歐 - ETG 則負責核心機械結構的制造。
磁懸浮系統能夠實現晶圓載臺的超精密運動,相較傳統氣浮系統,其振動幅度大幅降低。由于混合鍵合工藝對芯片裸片與晶圓之間的對位精度要求極高,這類精密運動技術正被逐步應用于該工藝,以提升產品良率和性能表現。
混合鍵合正成為推動先進封裝發展的核心技術支撐。與依賴微凸點實現連接的傳統熱壓鍵合不同,混合鍵合技術可直接實現芯片間銅面的互連,能大幅提升互連密度并降低電阻。該工藝要求設備具備裸片拾取、超精密對位以及壓力輔助鍵合的能力,對系統的精度和穩定性提出了嚴苛要求。
業內人士表示,阿斯麥布局混合鍵合領域并不意外。早在 2024 年,阿斯麥就推出了首款后端制程設備 ——TWINSCAN XT:260 3D 深紫外(DUV)光刻機,該設備專為先進封裝應用設計,可實現中介層重布線層(RDL)的圖形制備。此外,阿斯麥還推出了融合深紫外與極紫外光刻機的集成光刻解決方案,實現了約 5 納米的晶圓鍵合套刻精度,為其進一步布局高精度封裝工藝奠定了技術基礎。
阿斯麥首席技術官馬爾科?彼得斯此前曾表示,公司正密切評估半導體封裝領域的市場機遇,研究相關產品組合的構建策略。據悉,在研究了包括海力士在內的存儲芯片廠商的技術路線圖后,阿斯麥已確認市場對先進堆疊工藝設備存在明確需求。
市場層面,先進封裝領域的高速增長是阿斯麥布局該賽道的另一核心動因。設備供應商貝思(Besi)公布財報顯示,公司第四季度訂單積壓量同比激增 105%,這一增長主要由混合鍵合相關需求驅動。與此同時,先進半導體材料有限公司(ASMPT)預計,先進封裝業務將為公司貢獻約 25% 的總營收。
此外,應用材料公司也已入局該領域,與貝思展開合作研發 Kynex 芯片裸片 - 晶圓(D2W)混合鍵合系統,并整合了貝思的 Datacon 8800 Cameo Ultra Plus AC 平臺,進一步強化自身市場競爭力。
另有業內人士指出,阿斯麥掌握著全球頂尖的超精密控制技術,若其混合鍵合系統成功落地,或將深刻重塑當前先進封裝設備市場的競爭格局。不過阿斯麥方面表示,目前尚未正式啟動任何混合鍵合相關業務。




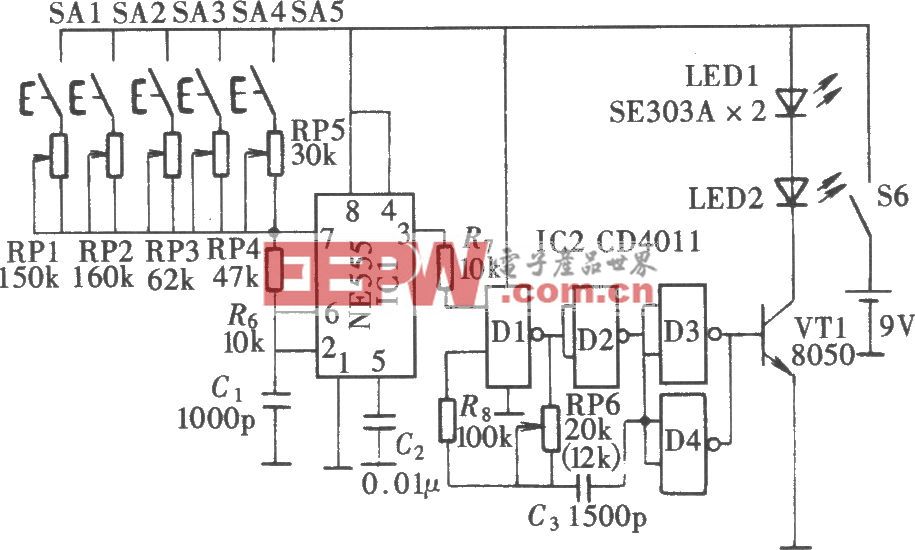



評論