光通信測試市場迎來新風口:CPO測試機遇深度解析
隨著 AI 數據中心集群持續(xù)擴容,數據傳輸需求急劇攀升,傳統銅互連技術已觸及物理性能極限。共封裝光學(CPO)目前被廣泛視作下一代 AI 基礎設施的核心互連方案之一。臺積電 COUPE 平臺預計將于 2026 年進入量產階段,標志著 CPO 技術正從實驗室研發(fā)全面邁向商業(yè)化落地。
然而,CPO 檢測與測試環(huán)節(jié)仍是行業(yè)顯著瓶頸。當前業(yè)界缺乏統一標準,工藝流程高度依賴人工操作,測試環(huán)節(jié)已然成為制約 CPO 芯片大規(guī)模量產的核心短板。
本文剖析 CPO 測試的各項技術難點,詳細拆解四大關鍵測試階段,并梳理當前主流設備廠商的落地解決方案與技術優(yōu)勢。
CPO 測試為何極具挑戰(zhàn)性
共封裝光學(CPO)將各類光學元器件集成至光子集成電路(PIC),再與電子集成電路(EIC)進行單芯片共封裝。CPO 以光路替代電路走線,有效降低功耗與傳輸時延。PIC 與 EIC 鍵合集成后的整體組件,被稱為光引擎(OE)。
臺積電 COUPE(緊湊型通用光子引擎)便是典型技術方案,依托 SoIC 面對面(F2F)堆疊工藝,將電子集成電路混合鍵合至光子集成電路,同時集成淺介電層通孔、嵌入式微透鏡與金屬反射器結構。
不同于僅開展純電性測試的傳統電子集成電路,光子集成電路內置大量光學器件,包括耦合器、調制器、光電探測器、光濾波器及光波導等。光引擎測試需要兼顧電學、光學與光電耦合交互等多領域專業(yè)能力,大幅提升了測試復雜度。
光子集成電路測試必須精準測量插入損耗、偏振相關損耗、響應度、波導傳輸損耗、光學串擾等關鍵參數,但目前行業(yè)尚未形成統一的測試規(guī)范與標準。
除此之外,光學探針的高精度對準是另一大技術難題。將光纖外部光源導入光引擎光波導的技術,稱為光耦合。單模光纖纖芯截面積約 78.5 平方微米,而光波導截面積僅約 0.099 平方微米,兩者差距接近 800 倍。若無納米級對準精度,將會產生極高的耦合損耗。
因此,光學探針的光纖陣列需與晶圓 / 裸片表面保持精準間隙,同時微調相對耦合器的入射角度,最大化光功率傳輸效率,再分不同波段依次完成測量。這類精密操作目前高度依賴人工,單顆光子集成電路全檢平均耗時超 100 秒,是阻礙 CPO 芯片量產落地的關鍵痛點。
附表:從測試原理、對準精度、行業(yè)成熟度、主流探針卡廠商四大維度,對比電子集成電路與光子集成電路測試要求差異
四大測試階段,OWAT 為何至關重要
單顆 CPO 芯片需依次完成四大測試環(huán)節(jié):
PIC 晶圓級測試:直流電性、基礎光學檢測,包含光功率、損耗、暗電流等基礎參數測量。
EIC-PIC 混合晶圓級測試:光電、電光、光光調制功能測試、高速信號測試與 S 參數檢測。
光引擎級測試:全流程校準、直流測試、高速測試、光學環(huán)回測試及 S 參數測量,是判定 ** 良品光引擎(KGOE)** 的核心環(huán)節(jié)。
先進封裝模塊級測試:整機全功能驗證與光學環(huán)回測試。
其中,PIC 晶圓級測試(OWAT)是最關鍵的前置環(huán)節(jié)。光子集成電路普遍采用成熟工藝制程,而電子集成電路依賴先進制程,成本高昂。若能在晶圓階段提前篩選出不良光子芯片,便可避免與高價 EIC 鍵合加工,大幅減少高端芯片報廢與后續(xù)制程損耗。

示意圖:CPO 制造流程與全流程測試階段,覆蓋晶圓驗收測試至系統級測試
供應鏈競爭格局
傳統電子集成電路自動測試設備(ATE)市場,長期由日本愛德萬、美國泰瑞達兩大巨頭壟斷。由于 CPO 測試設備需要同時具備 EIC 與 PIC 雙重測試技術能力,頭部廠商紛紛與光子探針專業(yè)企業(yè)深度合作:愛德萬攜手 FormFactor;泰瑞達則通過 2025 年收購 Quantifi Photonics,并合作 ficonTEC 補齊技術短板。
1. 愛德萬 × FormFactor
2024 年 6 月,愛德萬、業(yè)納與 Ayar Labs 聯合推出UFO 探針卡,將電探針與光探針集成于同一模組,可同步完成光電一體化測試。核心創(chuàng)新為對準容差補償技術:通過特殊整形光學出射光束,即便探針臺存在輕微定位偏差,光線仍可正常耦合進入 PIC 耦合器,大幅縮短對準耗時。
2025 年 4 月,愛德萬聯合 FormFactor 發(fā)布 V93000-Triton 光子測試系統,搭載九軸光子對準技術與 OptoVue Pro 光學對準系統。配套 CalVue 原位校準技術,依托特殊反射鏡光路設計結合機器視覺自動算法,實時校準 Z 軸位移與光學定位,進一步壓縮光纖對準時長。

2. 泰瑞達 × ficonTEC
2025 年 3 月,泰瑞達與德國 ficonTEC(現隸屬中國羅博泰克集團),推出業(yè)界首款面向硅光子量產的 300mm 雙面晶圓探針測試系統。ficonTEC 提供 WLT?D2 雙面晶圓測試平臺,支持 50 納米級超高精度對準;泰瑞達提供 UltraFLEXplus 自動測試設備與 IG?XL 系統軟件。
WLT?D2 的核心優(yōu)勢為雙面同步測試,可在晶圓上表面做電性測試、下表面開展光學測試,顯著提升測試效率。后續(xù)推出的 DLT?D1 雙面裸片測試系統,最多可并聯三組測試頭,提升產能、攤薄單顆測試成本。至此,ficonTEC 已形成從晶圓級到裸片級的完整 CPO 測試產品矩陣。
3. 致茂電子
致茂電子為全球半導體最終測試(SLT)設備龍頭,其 58604/58604?C/58606 系列光電二極管老化與可靠性測試設備,專為 3D 傳感、激光二極管、光電探測器、光調制器等光子器件設計。單模組層配備 256 個源測量單元通道,最高可疊加 7 層,合計 1792 通道。依托在半導體最終測試領域的光學技術積累,致茂已官宣投入研發(fā) CPO 專用測試設備。
4. 是德科技
全球測量儀器龍頭是德科技,深耕高速測試設備領域,同時提供完整 PIC 晶圓級測試方案。該方案與 FormFactor 深度整合,兼容其 Velox 探針臺控制軟件。
是德科技 N778x 系列偏振控制器可快速切換入射光偏振態(tài),搭配 N7700100C 偏振波長掃描軟件,依托矩陣算法自動計算插入損耗、偏振相關損耗、橫電 / 橫磁模損耗等參數。方案無需保偏光纖,也無需人工逐波長偏振校準,測試效率大幅提升。配套偏振態(tài)鎖定技術,可穩(wěn)定固定入射光偏振角度,保障全波段掃描過程中光耦合持續(xù)穩(wěn)定。
5. 光焱科技
2025 年 9 月,光焱科技聯手宜特科技發(fā)布Night Jar(夜梟)硅光子芯片測試平臺。該設備為外掛式高光譜成像分析系統,可兼容各品牌探針臺,適配晶圓測試、芯片驗證、成品測試等全流程環(huán)節(jié)。
該產品直擊行業(yè)長期痛點:傳統檢測僅能通過反射光粗略定位波導漏光位置,僅可獲取整體 / 平均光損耗數值。Night Jar 可精準定位漏光點位,單獨測量單段波導、單個光學元器件的量化插入損耗;結合可視化成像與晶圓級光損耗分布圖,助力研發(fā)人員快速精準定位缺陷,持續(xù)提升量產良率。
附表:CPO 測試設備供應鏈明細,涵蓋光學探針、精密量測儀器、測試系統、自動測試設備四大品類
市場發(fā)展機遇
隨著芯片設計架構日趨復雜,片上系統(SoC)測試難度持續(xù)攀升。單顆芯片所需測試工位數量、整體測試時長不斷增加,測試設備在半導體資本開支中的占比穩(wěn)步提升。
伴隨 CPO 芯片全面導入各廠商產品規(guī)劃,全球半導體行業(yè)針對測試設備的資本投入,預計將迎來進一步增長。







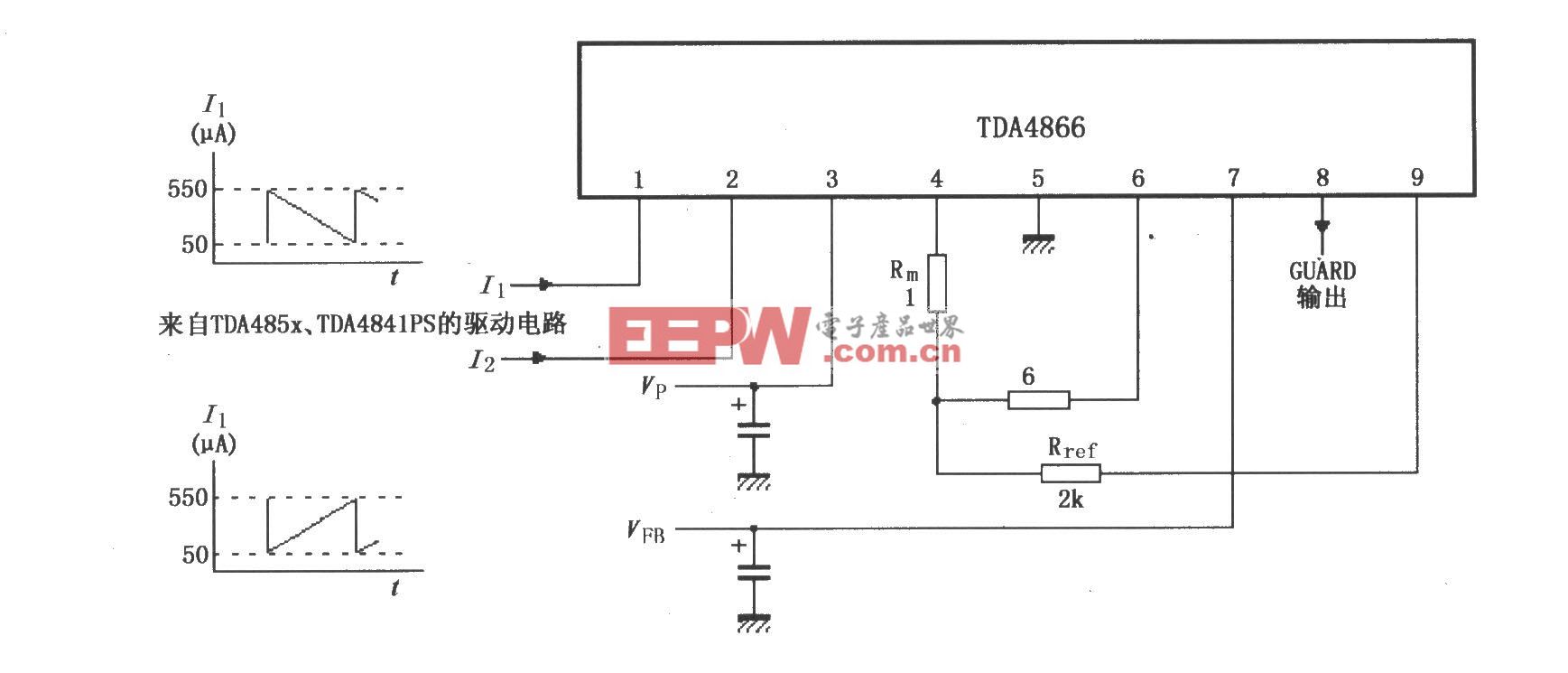
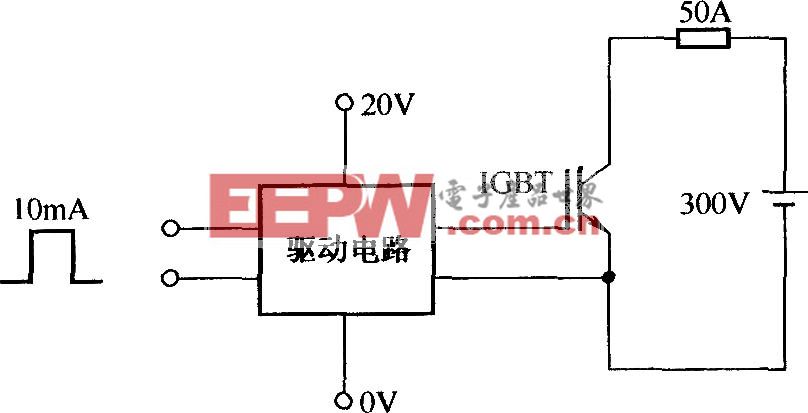
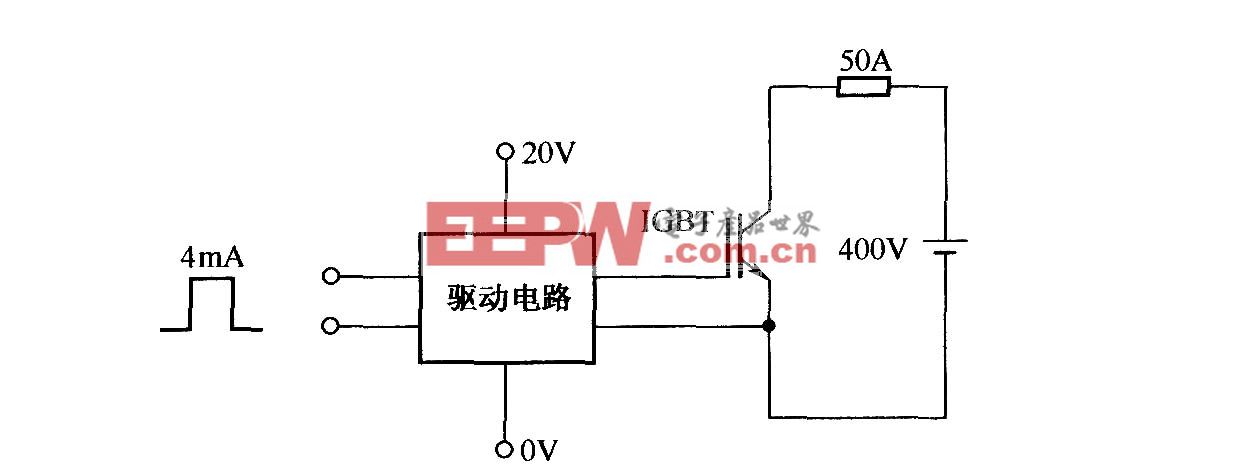
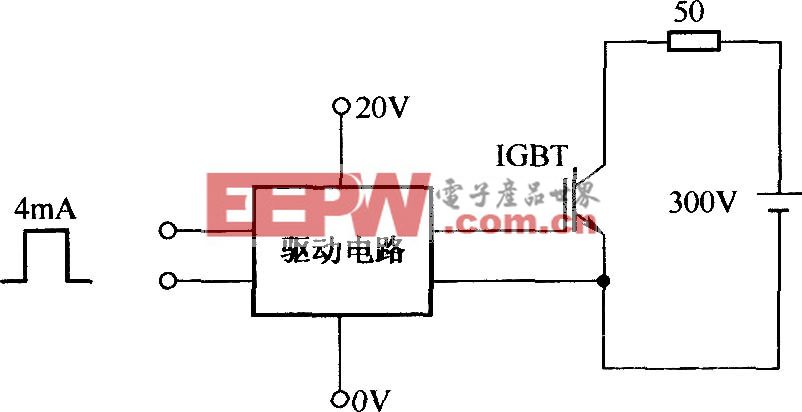
評論