優化功率轉換器的功率密度:頂部散熱封裝的作用
功率電子技術正在快速革新,新型材料和先進封裝技術不斷推動效率提升,并使更高功率密度成為可能。推動革新的關鍵因素之一,是先進封裝技術的集成,例如:英飛凌的頂部散熱(Top-Side-Cooled, TSC)Q-DPAK封裝(見圖1)。這類封裝通過將散熱路徑與電氣路徑分離,顯著提升了功率轉換器的性能。傳統上,硅基MOSFET和碳化硅MOSFET(如CoolMOS?和CoolSiC?)在功率轉換領域一直占據主導地位,而如今,頂部冷卻技術的優勢已在硅基及碳化硅功率器件中得到廣泛驗證。該技術可提升能效、實現更快開關速度,并支持器件在更高溫度下穩定運行。
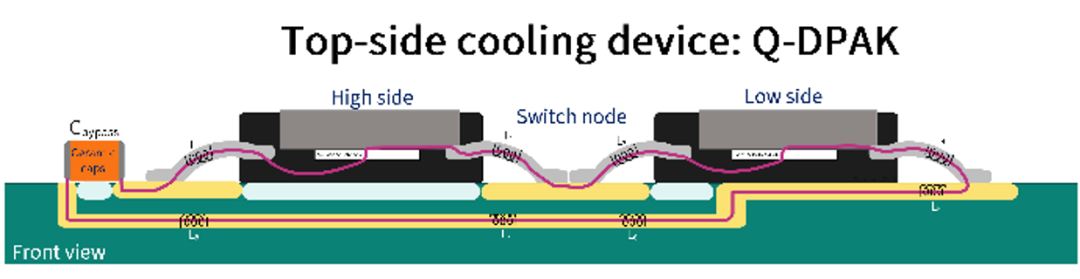
(a)
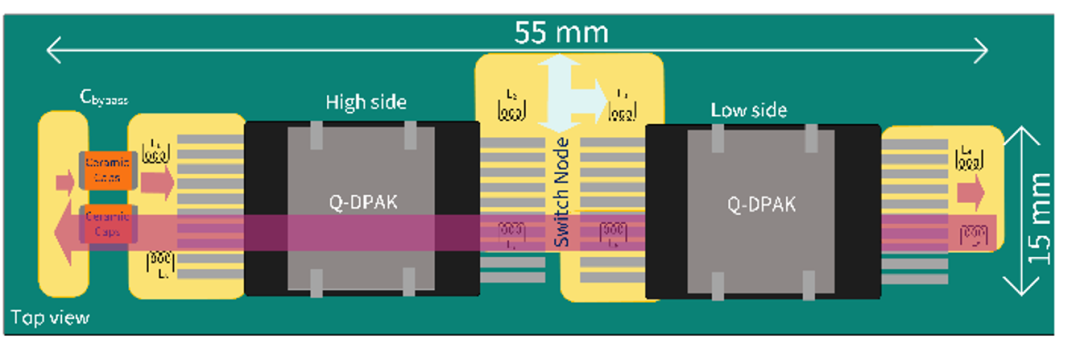
(b)
圖1:功率回路設計:
頂部冷卻器件的(a)側面圖和(b)頂部圖
封裝設計在功率轉換器優化中的作用
封裝設計是決定功率轉換器整體性能的關鍵因素之一(見圖2)。對于Si MOSFETs和SiC MOSFETs而言,功率轉換效率直接受到封裝選擇的影響。傳統的底部散熱(Bottom-Side-Cooled, BSC)封裝在功率器件底部設置散熱焊盤,通常需要借助額外的熱通孔(thermal vias)和PCB調整來滿足所需的散熱性能。然而,這種設計在機械堆疊結構上對散熱路徑形成約束,從而增加了熱管理的復雜性。
TO247-4
D2PAK
TOLT



(a)
(b)
(c)
Q-DPAK
H-D2PAK
H-DPAK



(d)
(e)
(f)
圖2:不同封裝形式下的功率回路設計:
a)TO247-4,b)D2PAK,c)TOLT
d)Q-DPAK,e)H-D2PAK,f)H-DPAK
盡管傳統的通孔(Through-Hole, THT)TO247封裝也采用了類似的熱堆棧結構,但在電氣性能方面,難以與TSC封裝匹敵。雖然兩種方案在散熱路徑上較為接近,但由于電流在封裝內部及相關PCB中的流動方式不同,TO247封裝往往表現出更高的寄生電感。這些配置中增加的寄生電感會對開關速度和效率產生不利影響。相比之下,TSC封裝能夠實現更優的電流路徑,并顯著降低寄生效應,從而在熱性能和電氣性能兩方面均帶來改善。TO247封裝中較高的寄生電感,通常限制了其在高頻應用中的使用,而在這類應用中,高開關速度和低損耗尤為關鍵(見圖3)。
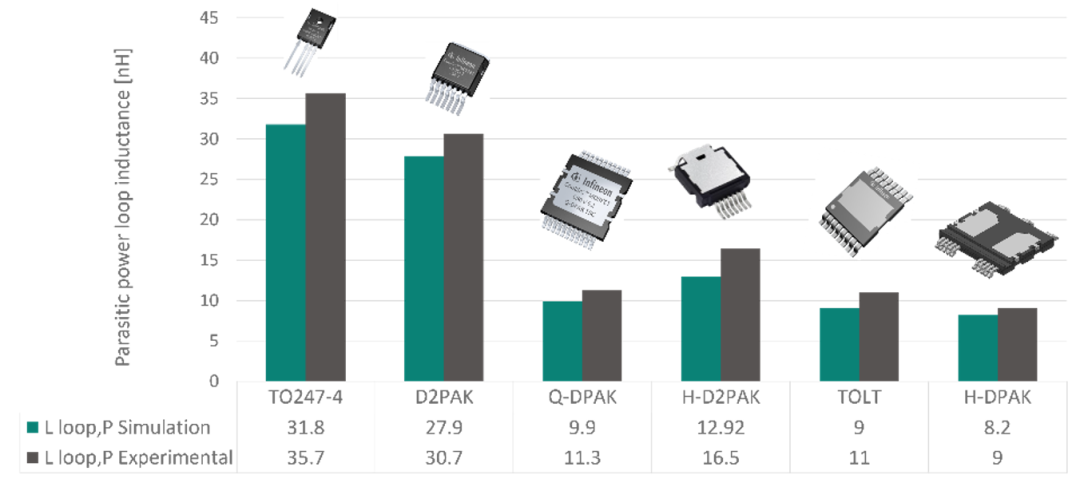
圖3:不同功率封裝的功率回路電感對比
諸如Q-DPAK等TSC封裝還具備一項顯著優勢,即可在封裝頂部直接連接散熱器或液冷系統。這種設計將散熱路徑與電氣路徑分離,從而提升散熱效率,并降低熱阻。借助TSC技術,功率器件和柵極驅動器可以布置在PCB的同一側,其中,柵極驅動器在理想情況下位于底部。相比之下,器件的散熱器則位于頂部,從而為設計提供更大靈活性和系統級集成度。
熱堆棧考慮因素:頂部冷卻與底部冷卻
頂部冷卻和底部冷卻之間的一個重要差異,體現在其對熱堆棧的影響上。采用底部冷卻時,熱量需要通過PCB進行散發,散熱焊盤位于封裝底部,這不僅挑戰散熱效率,還需為熱通孔預留額外PCB空間。此外,熱量在PCB內部擴散會限制散熱效率,并可能因器件局部積熱而導致板上其他元件溫升。
相比之下,采用頂部冷卻時,散熱系統可以直接安裝在器件頂部,從而提升散熱效率,并簡化整體的熱堆棧設計。散熱系統可以集成在封裝頂部,實現更加直接且高效的熱傳遞。這使得設計人員能夠創建更為緊湊的熱堆棧方案,減少對復雜熱通孔的依賴,并提升系統整體的散熱性能(圖4)。
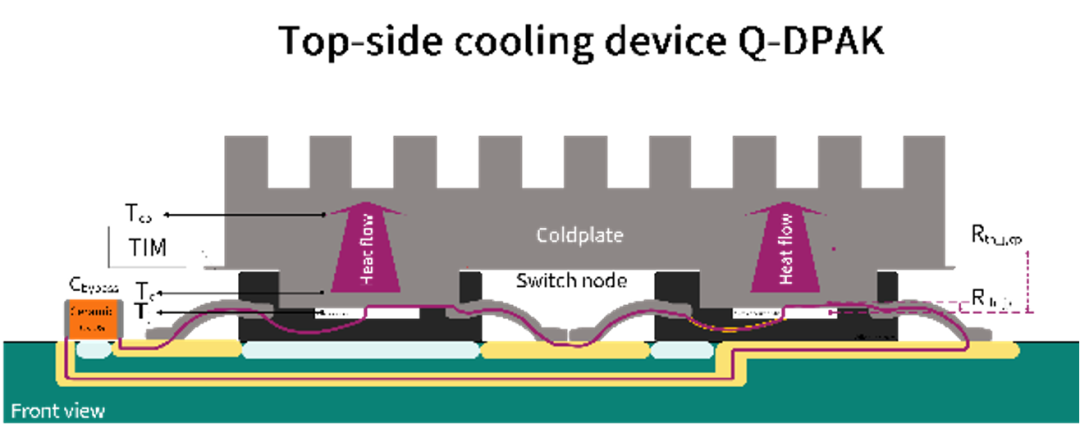
(a)

(b)
圖 4:(a)頂部冷卻和(b)底部冷卻器件的散熱概念
此外,由于冷卻路徑與功率回路相互分離,頂部冷卻為三維結構的設計提供了可能。這種分離對高功率密度設計而言大有裨益,因為在這類設計中,高效利用PCB面積至關重要。最終結果是功率轉換器具備更佳的可靠性和熱管理能力,從而在負載條件下,實現更高的功率密度和更優異的性能表現。
盡可能降低寄生電感:實現高速開關和高效率
在功率轉換器優化過程中,最小化寄生電感和電容是主要挑戰之一,特別是在高頻開關應用中。這些寄生參數(寄生元件)會顯著影響功率器件的開關行為,導致開關速度下降,并增加損耗。為了在功率轉換系統中獲得最佳性能,必須同時優化PCB布局以及轉換器中所采用的開關單元(SW-Cell)配置。
開關單元的設計決定了功率器件、柵極驅動器和其他相關器件在PCB上的布局。在設計開關單元時,必須對電流路徑、回路面積和整體布局進行周密考量,以降低寄生電感。降低寄生電感有助于實現更快的開關,從而通過降低損耗,來提升系統效率。
針對頂部冷卻封裝,通過將解耦電容布置在靠近功率器件的位置,可以對功率回路進行有效優化。這種配置能夠最小化感性回路面積,從而降低寄生電感,并提高開關速度。相比之下,底部冷卻系統往往由于需要額外的通孔,加上熱管理方面的考量,難以達到同等程度的優化,這些因素可能導致寄生電感增加,并降低系統效率。
開關單元設計:面向特定應用的布局優化
高效的功率轉換取決于開關單元的設計選擇,該設計決定了功率器件及其相關器件在PCB上的布局方式(見圖5)。
I-Loop開關單元是一種標準設計,其中MOSFET安裝在PCB底面,其余器件位于PCB頂面。這種配置雖然適用于許多應用,但在最大限度地降低寄生電感方面,存在一定局限,特別是在高頻系統中。
面積優化型I-Loop開關單元將柵極驅動輸入級布置在MOSFETs的另一側,從而優化PCB的可用空間。在保持較高開關性能的同時,該布局能夠降低寄生電感,特別適用于對功率密度和緊湊設計要求較高的應用場景。
U-Loop開關單元通過將開關節點與DC+和DC-端子分別布置在PCB的兩側,將它們隔離開來。雖然這種設計適用于空間受限的應用場景,但由于電流路徑布線優化不足,往往導致寄生電感較高,從而可能制約高頻應用中的開關性能。
最后,分體式電容半橋開關單元專為零電壓開關(ZVS)拓撲(如LLC轉換器)而優化。這種設計將諧振電容分布在DC+和DC-端子之間,有助于提高換向效率,并降低開關損耗。然而,這種設計需要精細的布局和更多的器件數量,因此比其他設計更復雜。

圖5:基于Q-DPAK TSC的高功率密度半橋開關單元方案:
(a)I-loop開關單元,(b)面積優化型 I-loop開關單元,
(c)U-loop開關單元和(d)帶分體式電容的半橋開關單元
系統級設計和熱管理
功率轉換器的性能不僅取決于電氣布局,還與熱設計和機械設計在系統層面的集成程度密切相關。熱管理對于確保功率器件在安全溫度范圍內運行、防止熱失控至關重要。
對于Q-DPAK等頂部冷卻封裝,由于散熱器或冷卻板可以直接安裝到封裝頂部,熱管理得以顯著簡化。這種結構能夠最大限度地降低熱阻、提升散熱效率,并減少對復雜熱通孔(例如:底部冷卻封裝中常見的內嵌銅PCB)的依賴。得益于更優異的散熱性能,功率轉換器能夠在不犧牲可靠性的前提下,實現更高功率密度運行。
機械設計同樣至關重要,特別是在器件密度較高的系統中。合理設計的PCB布局有助于最大限度地降低機械應力,這對于保持電路板的結構完整性并確保功率轉換器的長期性能至關重要。
實際測試:驗證設計優化效果
為了驗證上述設計策略的有效性,我們采用英飛凌的CoolMOS?和CoolSiC? MOSFET(采用Q-DPAK TSC封裝)構建了一款全橋評估板。該評估板采用4層PCB布局,并針對功率平面設計、垂直電流回路布線和磁場補償進行了優化(見圖6)。
系統級測試結果表明,優化布局后,功率回路電感降低至約7 nH,與仿真預測結果高度一致。這一結果表明,基于仿真的設計方法能夠成功應用于實際的功率轉換器中,從而實現更快的開關,并降低系統損耗。

圖6:Q-DPAK全橋評估板
此外,我們還通過對柵極驅動位置進行優化,盡可能降低寄生電容并確保信號完整性,從而進一步改善開關性能。這些結果驗證了在基于SiC的功率轉換器中,對電氣布局和熱管理進行優化的重要性。
結論
英飛凌的頂部冷卻式Q-DPAK封裝為基于CoolMOS?和CoolSiC?的功率轉換器在功率密度和系統效率優化方面,提供了一種極具吸引力的解決方案。通過將散熱路徑和電氣路徑分離,TSC封裝有效降低了寄生電感、提升了熱性能,并實現了更高效的功率轉換。
在高功率應用中,優化PCB布局、開關單元設計以及熱管理策略,是充分釋放碳化硅和硅MOSFET潛力的關鍵。通過合理的設計選擇,功率轉換器能夠實現更高效率、更快開關速度和更高可靠性,從而為下一代功率電子產品奠定基礎。












評論