測試與量測領域:設備匹配難度持續攀升
核心要點
工程師需結合器件專屬數據與設備級數據,定位工藝 “最佳區間”。
嚴格、高頻的設備間匹配可提升良率與晶圓廠靈活性。
機器學習能精準捕捉設備運行的細微 “特征信號”。
半導體行業之外的人常會好奇:人類如何日復一日、穩定地制造出幾十納米尺寸的晶體管?如何讓不同工藝設備、不同產線、不同廠區的加工結果保持一致?實現這一點的關鍵手段之一,就是設備間匹配(TTTM)。但隨著晶圓廠生產的芯片特征尺寸更小、工藝窗口更窄、復雜度更高,設備間匹配正變得越來越困難。
一片晶圓在 3 個月內通常要經歷600~800 道工序,所有設備必須輸出穩定一致的結果。負責檢驗結果的量測與測試系統,必須滿足行業最高標準。
Onto Innovation 應用工程總監 PeiFen Teh 表示:“最先進的工藝節點需要數百道高度關聯的工序,包括多重曝光、高 k / 金屬柵、復雜刻蝕化學、選擇性沉積、埋入式電源軌等。在整個制造流程中,每一處微小的工藝缺陷都會累積成復合效應,影響良率。因此,每道關鍵工序的設備間匹配規格,對確保全線工藝穩定至關重要。”
更短的產品生命周期、更快的良率爬坡需求,以及多元化的供應鏈,也給設備匹配帶來挑戰。泰瑞達智能制造產品經理 Eli Roth 說:“設備匹配變得更關鍵、更難做,因為我們的供應鏈分散、產品種類更多,還必須產出完全一致的測試結果。更復雜的器件要求更高透明度,安全裕量不斷收緊,先進封裝把更多裸片集成在一起,這都要求器件具備更高的重復性,進而迫使測試環節盡可能降低誤差來源。而且量產爬坡更快,新產品導入(NPI)在進入量產前的穩定時間更少。”
設備匹配(也稱腔體匹配)旨在讓同型號的自動測試設備(ATE)等輸出保持一致。實現方式有多種,首先會使用NIST 可溯源標準晶圓校驗關鍵尺寸(CD)等測量精度,再通過調整硬件參數讓關鍵輸出匹配。對于先進工藝,會用數據驅動的機器學習模型模擬設備間復雜的非線性偏差,晶圓廠再對機群中的其他設備重復這套流程。
有時會選用性能最優的設備作為基準。Roth 說:“行業廣泛使用黃金設備或測試載體。我們先用已知良好的參考載體完成標定,再將機群中其他設備與它做統計對齊。” 同時,量化測量系統自身的波動量也非常重要。
設備匹配不是一次性工作。工藝越先進,匹配頻率通常越高。以下場景必須執行設備間匹配:
設備安裝 / 驗收時
導入新產品或新工藝時
corrective 維護或預防性維護后
更換儀器或組件后
定期執行:如每天、每班、每批次(先進工藝)
要滿足頂尖器件廠商的需求,需要更多數據共享。Onto Innovation 應用工程總監 Melvin Lee Wei Heng 表示:“雖然廠商期望使用供應商提供的數據做基礎設備匹配,但器件制造商現在要求在關鍵工序實現更深層對齊,以保證器件性能一致。要達到這種匹配水平,需要獲取晶圓廠級別的器件數據,如量測結果與功能測試數據。結合器件專屬信息與設備級數據,現已成為確認設備運行在工藝最佳區間、并在全產線提供一致性能的必要手段。”
布魯克應用工程師 Andrew Lopez 說:“我們使用大量 VLSI NIST 可溯源標準做臺階高度與線寬測量。但除了系統校準,我們還會匹配光學系統,確保工藝配方從一臺設備轉移到另一臺時,照明設置不變、光學組件一致、系統照明一致。” 工程師可借助標準晶圓,將卡尺、傳感器等設備調整到嚴格公差范圍內。“我們會校驗多種臺階高度與線寬的線性度,確保系統足夠靈敏,能檢測到來自工藝的波動。”
設備匹配與設備指紋識別相關但并不等同。晶圓廠里的每臺設備 —— 光刻機、刻蝕機、清洗機、測試機、光學檢測系統等 —— 在機械部件或磨損痕跡上都存在微觀差異。即使運行相同配方,同型號設備的表現也會略有不同。通過捕捉與分析這些設備特征,工程師可以實現設備間性能對齊。
指紋識別是否受益于機器學習,需視情況而定。愛德萬測試云解決方案高級咨詢經理 Vincent Chu 表示:“傳統指紋方法依賴人工設計特征、控制圖與閾值對比,在低維、可預測的波動場景下效果良好。但如今測試設備采集的數據更豐富 —— 高分辨率參數、波形特征、時序測量、連續遙測數據。在這些高維空間中,ML 模型能捕捉定義設備真實運行‘特征’的細微非線性行為,能更準確、可擴展地表示測試設備的行為基線,而不完全依賴預定義指標。”
在量測與測試中,精密度與準確度都是重要指標。準確度指測量值接近真實值的程度,可通過與已知標準(如帶多種結構的標準晶圓)對比實現,但難度很高。
Fractilia 聯合創始人兼 CTO Chris Mack 說:“我們希望確保每一項量測輸出都可標記為準確,但幾乎不可能實現。我們幾乎總是先追求精密度,當長期穩定達到目標后,最終就能獲得良好良率。于是我們會稱其為‘準確’,但這并非 NIST 標準量測結果意義上的準確數值。盡管如此,精密度仍是我們最關注的量測設備核心特性。”
精密度由多次測量同一結構并記錄中心值周圍的波動程度決定。
設備匹配如何工作
需要匹配的指標因設備類型而異。例如在聲學顯微鏡成像中,指標包括圖像強度、信號幅度、深度響應與缺陷檢出能力。諾信聲學顯微鏡產品線經理 Bryan Schackmuth 說:“我們采用長期穩定性監測(LTSM)或全局設備匹配。它使用已知參考樣品與軟件算法,通過歸一化聲學圖像響應補償系統間差異,確保不同設備、不同廠區的檢測結果一致。LTSM 可實現圖像歸一化,無需操作員手動調整就能獲得匹配圖像。這種全局匹配流程通常在工作頻率變更(如更換探頭)、每班開始前或每天執行。”
量測數據與電學測試結果的關聯越來越緊密。Onto Innovation 產品管理總監 Joe Fillion 說:“設備匹配通常基于步驟層級執行,每家晶圓廠或原始設備制造商(OEM)的做法略有差異。首先做指紋或配置對比,設備需在軟硬件層面盡可能匹配 —— 相同軟件版本、鏡頭、光闌、光源、質量流量控制器(MFC)等。達到合理匹配后,設備通常執行標準自動測試或校準流程,確保行為一致。若結果符合規格,再執行標準認證流程,測量晶圓上的實際性能。這些結果會設定目標值與上下限,確保運行在可接受區間。”
Onto 的 Teh 給出了設備匹配的分步指南:先對齊每個設備組件的性能,再監控機群匹配水平,包括:
組件級校準:監控系統健康檢查參數,超標時執行校準
系統級校準:在標準晶圓上測量機群設備的光譜響應
光譜校準:用于提升機群匹配水平
參數結果監控:使用標準晶圓(測量 CD、厚度或材料常數),必要時重新校準以優化各參數的設備匹配度
在測試設備上,工程師需要管控組件漂移。泰瑞達的 Roth 說:“熱傳感器會隨時間漂移,存在時序偏移。我們通常通過定期校準與參考檢查管理漂移,并持續將設備與參考掃描儀對比,明確偏差程度與校準時機。統計過程控制(SPC)監控與大數據監控是其他檢測方式。我們會持續進行周期性計算。”
根據設備配置,部分設備級校準可內置實現。Modus Test 首席運營官 Jesse Ko 說:“我們的測試機基于高精度電阻,采用自校驗方法確保每次測量準確,以此確認每臺設備已校準,并在多臺測試機間提供一致測量結果。”
電學測試與量測通常協同工作。Onto 的 Melvin 說:“晶圓廠已集成在線電學 / 功能測試,確保設備性能不會對器件產生影響。在部分關鍵工序,會進行截面分析,確保敏感層形成的輪廓符合器件規格,彌補傳統量測的不足。”
另一種思路是從結果倒推,而非從設備出發。英特爾當年的 “精準復制”(Copy Exact)策略 —— 在廠區完全復刻設備、方法、工藝 —— 卻產出不同結果,最終將波動原因鎖定在濕度等環境條件。校準設備可能只是復雜排查的第一步。
PDF Solutions 全球晶圓廠應用解決方案經理 Jon Holt 說:“設備型號相同、校準相同,要確保測量準確,因為這是不同廠區間波動的潛在來源。可以在同一位置測量或使用同一臺設備。但還要更全面、整體地看待環境變量:冷卻水、供氣、氣體分配是否一致,并整合所有必要信息。最終真正的挑戰是功能性:組件是否按預期工作?器件電流、擊穿電壓、增益、速度是否達標?并不是插上前向糾錯(FEC)工具、匹配所有傳感器輸出,腔體就匹配了,但愿能這么簡單。”
“熄燈” 晶圓廠
隨著行業邁向全自動化運營,設備間匹配將與生產結合得更緊密。Roth 說:“它將從周期性校準驅動,轉向持續數據驅動的監控系統。不再需要拿著參考卡反復檢查,而是實現持續自動化監控與告警 —— 比現有方案更智能的版本。”
值得注意的是,不久前,現場的獨立 CD-SEM 還不做匹配。Fractilia 的 Mack 說:“我們最初并未計劃推出改善設備間匹配的產品。但我們發現,通過測量 CD-SEM 誤差并從量測結果中剔除,以提升量測準確度的方案,自然帶來了更好的設備間匹配。在 CD-SEM 上疊加我們的技術,設備間匹配性能提升了10 倍。”
CD-SEM 的下一步是管控隨機效應。“CD-SEM 間的設備間匹配非常困難,因為所有關鍵尺寸的公差都在收縮。再加上線寬粗糙度、線邊緣粗糙度、CD 均勻性等隨機效應的設備間匹配需求,這是行業從未做過的事,我們相當于在開創方法。”
由于信噪比維持難度上升,量測領域開始轉向機器學習。Onto 的 Teh 解釋:“隨著結構尺寸縮小,需要匹配的對象更難測量。我們預計亞 1nm 參數的光譜靈敏度將接近量測設備的噪聲底。部分極小尺寸參數會被更敏感的參數掩蓋。在這種場景下,ML 模型可用于放大關鍵信號。”
除放大信號外,ML 模型還能有效管理設備指紋,記錄并識別設備的變更,將這些變更與設備性能(硬件、軟件、晶圓結果)關聯,提升對因果關系的理解。建立可信度后,下一步將是自動化決策。
愛德萬的 Chu 說:“ML 將設備指紋從人工定義統計,升級為學習型行為表征,在先進測試系統在大批量機群中產生海量數據的場景下尤其有用。ML 還能增強異常檢測,這對量產測試至關重要。通過學習特定測試單元的正常行為模式,模型能比靜態閾值更早、更可靠地識別由校準漂移、組件老化、環境變化或負載板效應引起的早期偏差。在多設備機群中,ML 能凸顯可能影響分 bin 或相關性的測試設備差異。需要強調的是,ML 是補充而非替代傳統統計方法。”
結論
設備間匹配對晶圓廠與測試廠并非新工藝,但隨著器件微縮、復雜度提升、工藝窗口收縮、公差收緊,難度顯著增加。在2nm 節點,量測系統已逼近物理極限,任何信噪比提升都備受期待。
例如,工程師測量 3nm 結構時,套刻精度要求低于0.3nm。要實現這一點,必須對線邊緣粗糙度、線寬粗糙度、CD 均勻性的隨機效應建模,才能完成 CD-SEM 設備間匹配。
工程師通常從對比設備特征開始,將設備匹配細化到組件級。從組件到系統再到參數校準,在機器學習助力下,匹配變得更精密、更自動化。要在量測領域實現更精細的設備間匹配,工程師需要接入晶圓廠的電學測試數據,確保最終獲得晶圓廠真正需要的結果:每次都產出高良率、高性能芯片。設備間匹配在保障高良率方面發揮關鍵作用,尤其在最先進的器件節點。




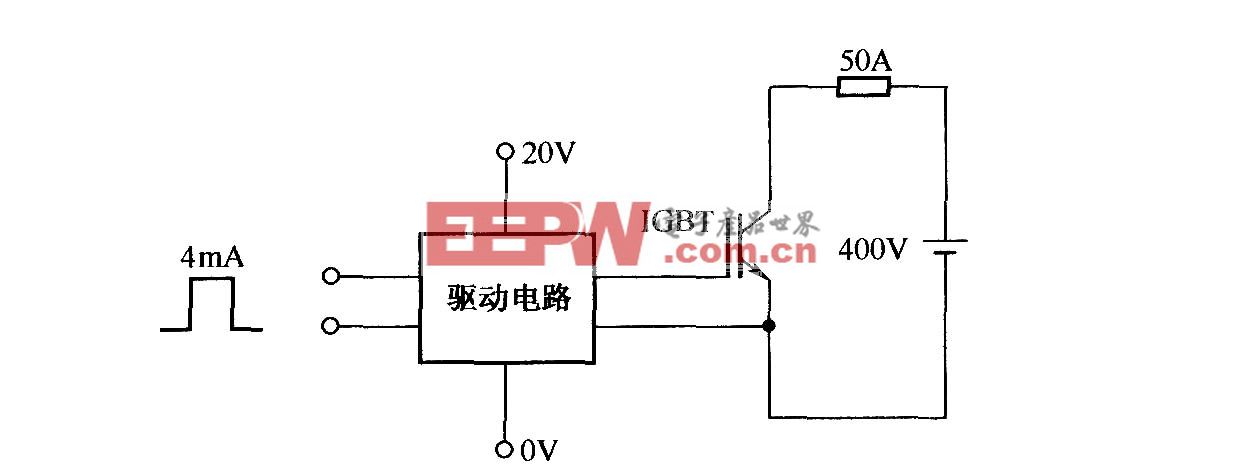
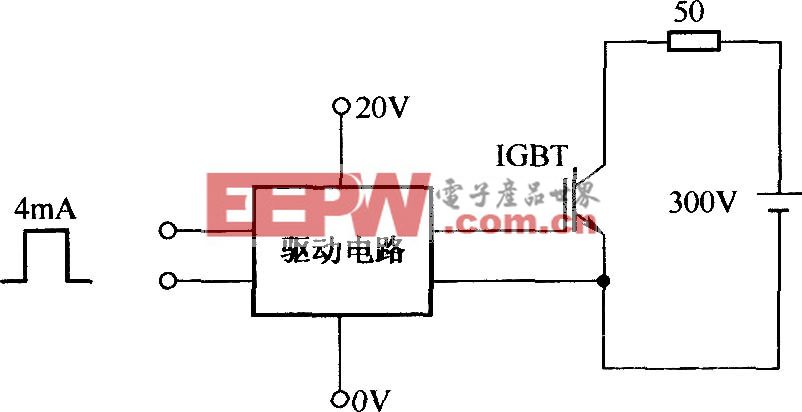
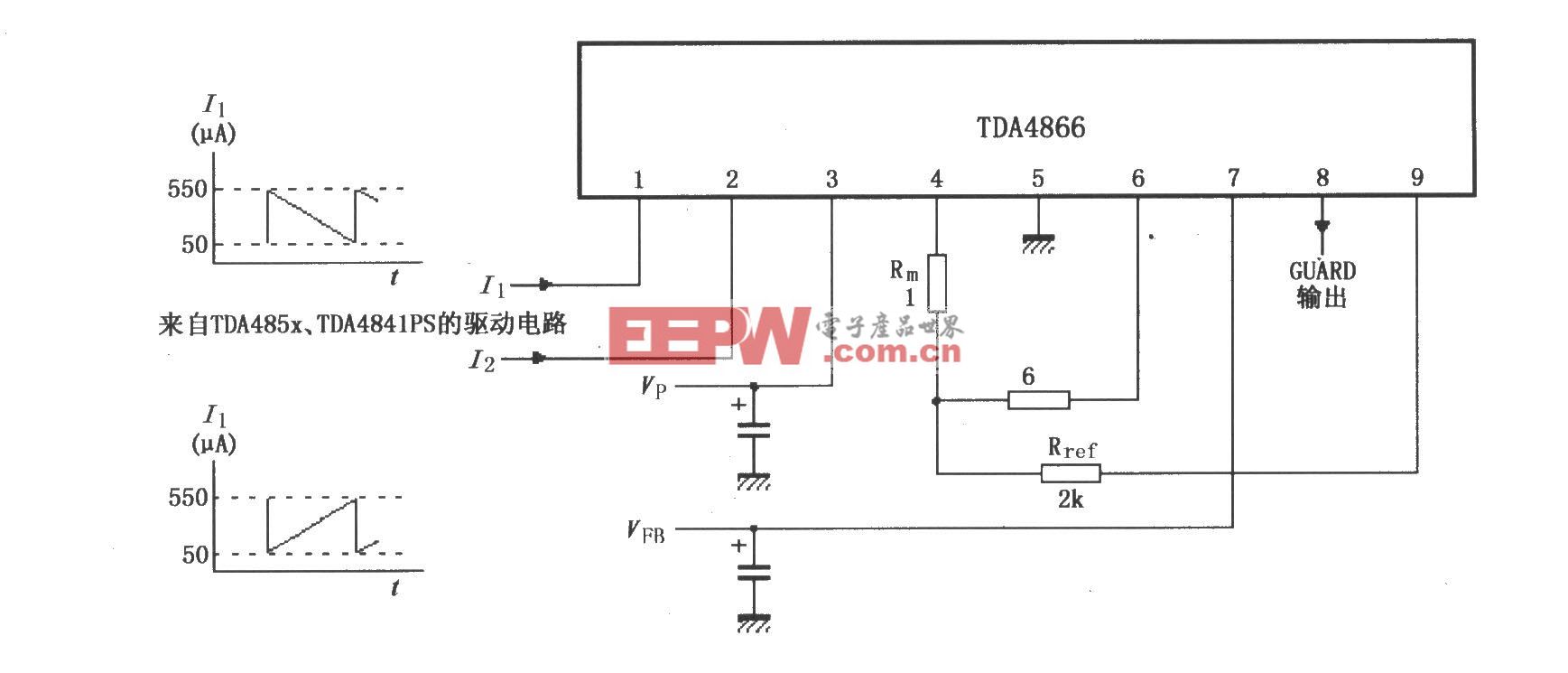
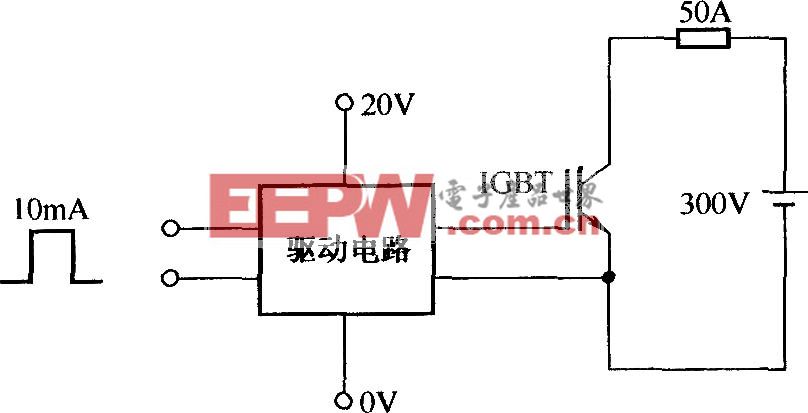
評論